作为存储领域极少数具备自主封装测试能力的厂商之一,记忆拥有完整的封装设计、仿真、可靠性验证和先进封测制造能力。通过自主研发创新,已掌握大容量、高密度、超薄系统级产品封装测试的核心工艺,并完成产品的多次迭代。


拥有先进的SIP系统级封装及测试整体解决方案,可将多个不同芯片通过3D堆叠集成在同一个封装体内,形成一个独立的器件系统,以实现及满足多功能、小尺寸、高性能、低功耗、高可靠性的产品及市场需求。

记忆是国内封测行业中第一家引入超薄晶圆加工工艺的企业,3D Flash晶圆研磨切割能力可达50um以下,拥有SDBG、Edge Trimming、Laser grooving等核心工艺,可深加工各种不同的晶圆,工艺能力达到国际先进水平。

拥有国际领先的无顶针叠晶工艺,实现超薄晶圆的叠晶,最高单颗芯片可容纳32颗存储芯片,达到TB级容量的封装产品;
最终封装厚度:DDP(2叠DIE)、QDP(4叠DIE) 的产品厚度在1.0mm以内;ODP(8叠DIE)的产品厚度在1.2mm以内;HDP(16叠DIE)的产品厚度在1.4mm以内。

记忆拥有金线、银线、铜线等多种焊线工艺,拥有超低线狐工艺能力、超薄芯片产品的焊接能力。
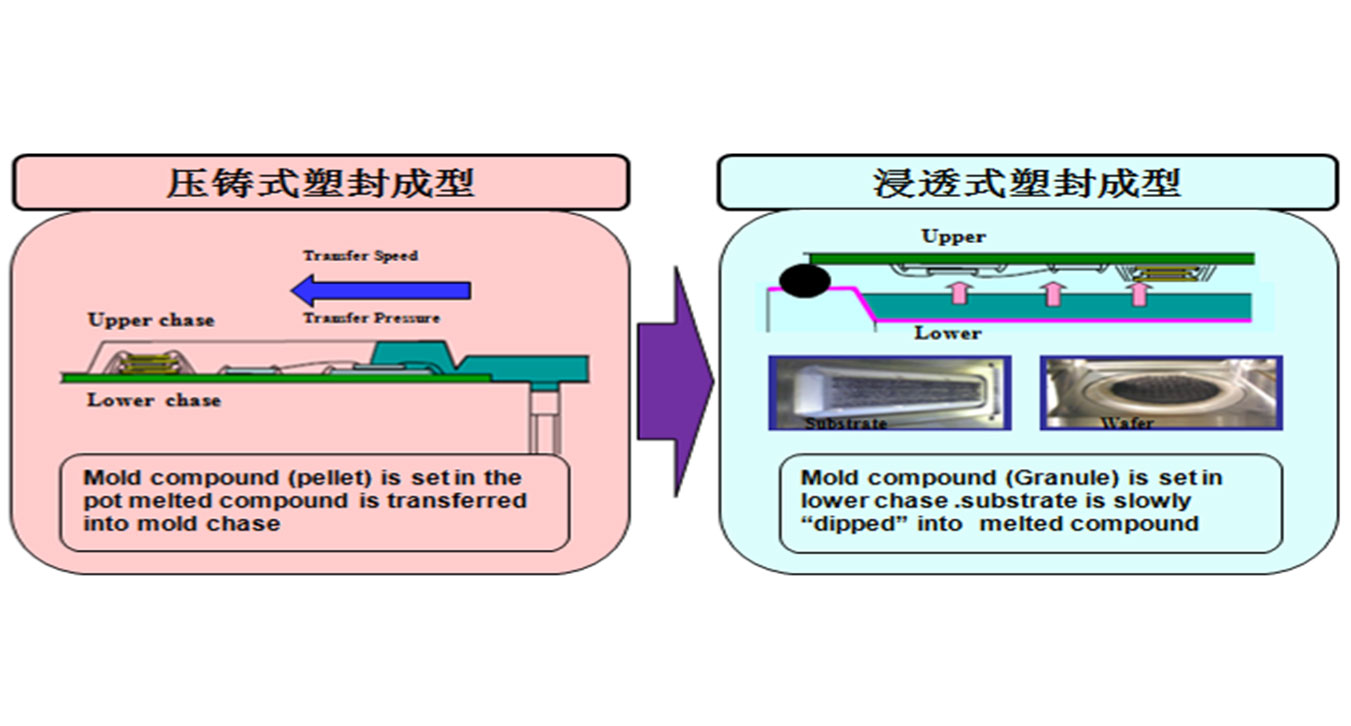
从压铸式塑封升级为浸入式塑封,使封胶制程更稳定。拥有超薄基板应对能力,实现高堆叠,细间距封装低压力应对,产品无气孔、无流痕、无冲线;同时,柔性可调节产品厚度的能力。

自封颗粒老化是采用自主研发且拥有专利的测试系统,具备存储行业专用的ATE测试机台测试开发能力。记忆还建立了测试大数据系统,支持端到端的测试数据追踪,并拥有大数据分析及应用能力、海量测试治具使用监控能力,为智能制造及远程监控打下坚实的基础。